Почему вам нужны наши услуги, вы знаете, что получаете высококвалифицированных специалистов, обладающих знаниями и опытом, чтобы убедиться, что ваш проект выполнен должным образом и функционирует.

Диоды и транзисторы с каналами AlN обеспечивают высокие напряжения пробоя и работают при невероятно высоких температурах.
Ряд видов человеческой деятельности перерастает в экстремальные условия, часто мотивированные эксплуатацией ресурсов. Это потребовало проведения исследований в различных направлениях, в том числе глубоко под землей, на больших глубинах моря и в глубоком космосе. Во всех этих средах температура экстремальная – она превышает 300 °C на поверхности Венеры, при бурении глубоких скважин и в пространстве внутри работающего двигателя.
Чтобы узнать больше обо всех этих средах, необходимо использование датчиков. Но самые очевидные из них, то есть кремниевые, не справляются с этой задачей из-за относительно низкого предела рабочих температур. Это означает, что для того, чтобы обогатить нашу жизнь этими средами, нам необходимо разработать электронику, работающую при экстремальных температурах.
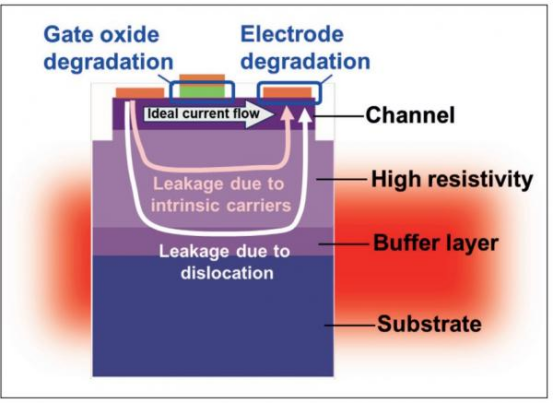
Рисунок 1. Путь тока утечки и точки термической деградации в MESFET с оксидом затвора.
Когда все виды полупроводниковых устройств работают при экстремальных температурах, они сталкиваются с проблемами, связанными с материалами, электродами, оксидами затворов и упаковкой (см. Рисунок 1). При повышении температуры образуются многочисленные электронно-дырочные пары из-за возбуждения электронов из максимума валентной зоны в минимум зоны проводимости. Эти электроны, которые увеличивают концентрацию собственных носителей (см. рисунок 2 (а)), вредны, так как увеличивают ток утечки устройств и не позволяют им выключиться. Варианты уменьшения тока утечки включают введение полупроводниковых материалов с большей энергией запрещенной зоны и более низкой концентрацией собственных носителей (см. Рисунок 2 (б)) или ограничение диффузии тока из областей, отличных от канала. Обращение к канальному слою, окруженному высокоомными слоями с низкой эффективной концентрацией доноров/акцепторов и низкой концентрацией дефектов, может повысить рабочую температуру устройства. Другой подход — развертывание устройств с pn-переходами, таких как JFET и BJT. В этих случаях также важно выбирать для электродов тугоплавкие металлы, обладающие минимальной реакционной способностью с основными полупроводниками. В частности, титан, ванадий, тантал, молибден, вольфрам и платина лучше подходят для этой цели, чем алюминий, магний, медь, серебро, индий и золото.
Зачем использовать АлН?
Существует множество полупроводниковых материалов с большей шириной запрещенной зоны, чем у кремния. К ним относятся SiC (3,3 эВ), GaN (3,4 эВ), Ga2O3 (4,7–5,2 эВ), алмаз (5,5 эВ) и AlN (6,1 эВ). Команда НАСА под руководством Филипа Нойдека сообщила, что SiC JFET могут работать при температурах выше 800 °C. Хотя это, несомненно, впечатляющий результат, материалы с еще более широкой запрещенной зоной обещают достигать еще более высоких температур. Однако многие из них имеют существенные недостатки. GaN страдает от высокой эффективной концентрации доноров, равной 1016 см-3; невозможно образовать Ga p-типа2O3 слои; а алмаз начинает реагировать с кислородом примерно при 700 °C. В отличие от этого, AlN не имеет очевидных недостатков и обеспечивает термическую стабильность и контролируемое легирование. Благодаря этим качествам наша команда в Университете Цукубы уделяет все внимание AlN при разработке устройств, работающих при экстремальных температурах.
Исторически считалось, что AlN хорош только как изолятор. Однако около 20 лет назад Ёситака Таниясу и его коллеги из NTT продемонстрировали, что это не так, выращивая электропроводящие слои AlN с помощью MOCVD.
Эта команда зафиксировала подвижность электронов 426 см-1.2 V-1 s-1 для слоев AlN, легированных кремнием, при концентрации легирующей примеси 3 x 1017 см-3. Основываясь на этой работе, они стали пионерами в выращивании AlN p-типа и продемонстрировали первые светодиоды AlN с длиной волны 210 нм и квазивертикальные p-n-диоды AlN. Этим успехам обязана недавняя быстрая разработка светодиодов глубокого УФ-излучения на основе AlGaN и AlN.
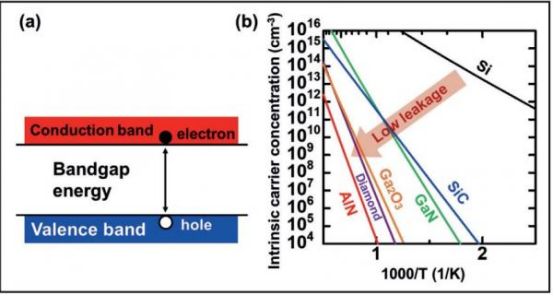
Рис. 2. (а) Иллюстрация генерации электронно-дырочных пар при высоких температурах. (б) Концентрация собственных носителей кремния, SiC, GaN, алмаза β-Ga2O3 и AlN в зависимости от обратной температуры.
Помимо оптических устройств, исследовательское сообщество исследовало диоды с барьером Шоттки AlN и HEMT AlN/AlGaN, чтобы изучить потенциальные преимущества высокого критического электрического поля. К сожалению, эти устройства страдают от низкой концентрации носителей из-за высоких энергий ионизации доноров и акцепторов – она составляет 0,3 эВ для кремния и 0,6 эВ для магния. Из-за этого концентрации носителей для обеих этих примесей примерно на два порядка ниже их концентраций, из-за чего устройства имеют очень малые токи. Чтобы решить эту проблему, наша команда в сотрудничестве с исследователями из Массачусетского технологического института и Университета Аалто открыла новые горизонты, внедрив индуцированное поляризацией легирование в N-полярные структуры AlGaN/AlN. Благодаря спонтанной и пьезоэлектрической поляризации эта форма легирования может увеличить ток и снизить сопротивление контакта. Используя поляризационно-индуцированное легирование, мы продемонстрировали первые N-полярные PolFET и HEMT на основе AlN с токами стока более 100 мА/мм-1. Такой успех позволил нам рассматривать AlN как практичный полупроводник для оптических и электрических устройств.
Для производства этих устройств мы смогли привлечь ряд поставщиков материалов. Высококачественные образцы AlN на 2-дюймовых сапфировых подложках можно приобрести у Dowa Electronics Materials, а 2-дюймовый объемный AlN коммерчески доступен у Stanley и Asahi Kasei.

Рис. 3. (а) Профили концентрации примесей кремния, кислорода и углерода по глубине в имплантированном кремнием слое AlN толщиной 3 мкм после отжига при 1600 °C. (б) Профили концентрации магния по глубине в имплантированном магнием слое AlN толщиной 1 мкм после отжига.
Допинг AlN
Контроль концентрации легирующих примесей в полупроводниках осуществляется путем внедрения примесей во время роста кристаллов, а также термодиффузии и, возможно, имплантации. Последняя представляет собой привлекательную технологию, позволяющую точно контролировать дозу и обеспечивающую высокую латеральную однородность легирующей примеси. Однако при имплантации высоких доз они имеют тенденцию повреждать кристаллические решетки и вводить высокие концентрации точечных дефектов, которые могут компенсировать носители. К счастью, большую часть этих повреждений можно устранить с помощью посттермического отжига, который мы использовали при изготовлении имплантированного в кремний канала AlN n-типа.
Одной из впечатляющих особенностей кристаллов AlN, включая их поверхность, является прочность при повышенных температурах и стабильность в газообразном азоте при температуре до 1700 °C. Такая надежность обеспечивает широкие возможности для устранения повреждений, нанесенных имплантацией: этот процесс требует температур выше 1200 °C для электрической активации имплантированного кремнием слоя AlN. Однако обратите внимание, что при выборе температуры отжига необходимо тщательно обдумать, поскольку она может вызвать другие изменения в материале. За пределами 1400 °C примеси кремния и кислорода диффундируют в верхний слой. Из-за диффузии атомов кислорода из сапфировой подложки, которая разлагается при 1500 °C в атмосфере азота, тонкий слой AlN на сапфировой подложке после высокотемпературного отжига будет иметь высокую концентрацию кислорода, что приведет к ухудшению электрических характеристик.
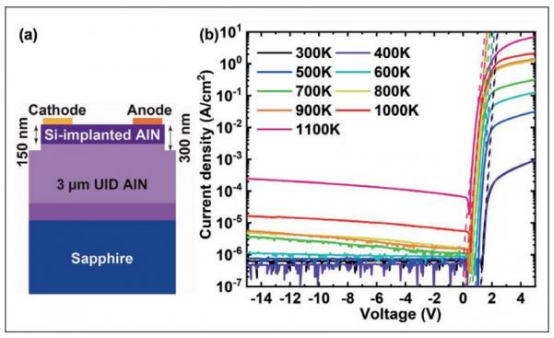
Рис. 4. (а) Поперечное сечение диода с барьером Шоттки с имплантированным в кремний каналом AlN. Анод Ni/Au и катод Ti/Al/Ti/Au. (б) Вольт-амперные характеристики AlN-диода с барьером Шоттки в диапазоне от 27 °C до 827 °C.
Благодаря сотрудничеству с Массачусетским технологическим институтом, Университетом Аалто, TNSC и Dowa Electronics Materials мы исследовали диффузию атомов кремния, кислорода и магния в AlN (см. рисунок 3). Наши исследования показали, что атомы кислорода, диффундирующие из сапфировой подложки, не могут достичь канального слоя после отжига при использовании слоев AlN толщиной 3 мкм. Это привело нас к выводу, что предпочтительные диапазоны температур отжига электропроводящих слоев AlN с кремниевыми и магниевыми имплантатами составляют 1200–1600 °C и 1400–1500 °C соответственно. Эти знания позволили нам продемонстрировать первые транзисторы с каналом AlN.
При изготовлении приборов в условиях, близких к тепловому равновесию, таких как эпитаксиальный рост и высокотемпературный отжиг, благоприятствует образование глубоких состояний с энергиями ионизации 250-320 мэВ. Это имеет тенденцию приводить к самокомпенсации донора кремния, что согласуется с нашими результатами.
Между тем использование неравновесных процессов, таких как ионная имплантация, позволяет увеличить популяцию мелких доноров с энергиями ионизации 64-86 мэВ. Это побудило Хайдена Брекенриджа и его коллег из Университета Северной Каролины и компании Adroit Materials создать высокопроводящий слой AlN путем имплантации кремния и последующего отжига при относительно низкой температуре 1200 °C. Еще один обнадеживающий результат, полученный в Киотском университете, заключается в том, что замещающая энергия связи AlN с акцептором магния составляет всего 250-410 мэВ, что намного меньше энергии ионизации акцепторов магния в обычных слоях AlN, выращенных методом MOCVD. В совокупности эти результаты показывают, что если неравновесные условия процесса можно будет воспроизводимо и легко контролировать в AlN, легированном кремнием и магнием, это может открыть двери для электронных и оптических устройств со значительно улучшенными характеристиками.
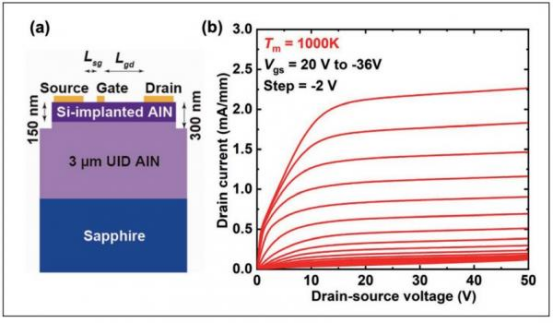
Рис. 5. (а) Схематическое сечение MESFET с имплантированным в кремний каналом AlN. (б) Выходные характеристики постоянного тока AlN MESFET при 727 °C.
Электрические свойства AlN
Чтобы улучшить электрические характеристики устройств на основе AlN, необходимо сделать больше, чем просто решить проблему высокого удельного сопротивления слоев AlN n-типа и p-типа, которое ухудшается из-за низкой концентрации носителей заряда. Кроме того, необходимо решить проблему высокого контактного сопротивления, возникающего из-за малого сродства к электрону.
Особенно сложно создать омический контакт в AlN при комнатной температуре. Падение напряжения определяется высотой барьера Шоттки, которая зависит от разницы между работой выхода металла и сродством полупроводника к электрону. Омические контакты можно создать, уменьшив высоту потенциального барьера за счет соответствующего подбора материалов электродов. Вариантами AlN n-типа являются титан, алюминий, ванадий и молибден, тогда как в омических контактах с AlN p-типа могут использоваться палладий и NiO.
Одним из последствий сильного легирования полупроводниковых материалов является уменьшение ширины области обеднения, что приводит к туннелированию через потенциальные барьеры. Сильное легирование верхней поверхности AlN очень важно для омических контактов. Однако, поскольку концентрация легирующих добавок кремния и магния в слоях AlN ограничена примерно 1019 см-3, возможно, из-за образования компенсационных дефектов, перспектива автоэмиссионного туннелирования отсутствует.
Чтобы определить концентрацию и подвижность носителей в полупроводниковых структурах, исследователи склонны обращаться к измерениям эффекта Холла. Поскольку для этих измерений необходимо омическое поведение, в некоторых исследованиях использовались сильно легированные контактные слои GaN. Это позволило определить электрические свойства AlN как при комнатной, так и при повышенных температурах. Наряду с другими, мы оценили концентрацию носителей и их подвижность при высоких температурах, получив значения для AlN n-типа и p-типа при температурах выше 200 °C и 500 °C соответственно.
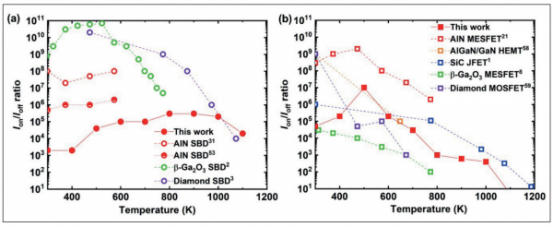
Рисунок 6. Сравнительный график, сравнивающий коэффициент включения-выключения тока с температурой измерения устройств AlN с другими современными (а) диодами с барьером Шоттки и (б) полевыми транзисторами.
Проводя данное исследование, мы обнаружили новую проблему, связанную с измерениями высоких температур. Нам пришлось использовать зондовую станцию, так как не хватало технологий склеивания и упаковки для экстремальных температур. Мы также обнаружили, что обычные наконечники зондов портятся при высоких температурах. Обратите внимание, что большинство зарегистрированных устройств имеют максимальную рабочую температуру не более 500 °C, а это означает, что измерения электрических свойств ненадежны при температурах выше этой.
Работая с Dowa Electronics Materials, мы оценили электрические характеристики слоев AlN толщиной 3 мкм на сапфировых подложках с помощью высокотемпературной системы датчиков, обеспечивающей максимальную температуру измерения 900 °C в высоком вакууме. Для этой цели мы имплантировали кремний в слой AlN при комнатной температуре, чтобы получить проводимость n-типа; концентрация составила 2 × 1019 см-3 в профиле коробки глубиной 150 нм. Эти имплантированные кремнием слои AlN были впоследствии отожжены при температуре 1500 °C. Затем мы нанесли электроды Ti/Al/Ti/Au для омических контактов перед спеканием при 950 °C.
Наши электроды испортились при 877 °C, возможно, из-за реакции между Ti/Al и AlN. Это побудило нас искать подходящие металлы для омических контактов при экстремальных температурах. Для температур, которые мы смогли рассмотреть, мы наблюдали зависимость ток-напряжение, которая нелинейна ниже 127 °C и почти линейна выше 227 °C. Оценка электрических свойств в диапазоне от 227 °C до 827 °C показала, что поверхностное сопротивление и контактное сопротивление уменьшаются с увеличением температуры. От 227 °C до 627 °C с повышением температуры подвижность электронов немного падала, но концентрация электронов увеличивалась за счет усиленной ионизации доноров, что приводило к снижению поверхностного сопротивления при высоких температурах. Это привело нас к выводу, что слои AlN n-типа демонстрируют превосходные характеристики при экстремальных температурах.
Диоды и транзисторы
Мы изготовили диоды с барьером Шоттки и МОП-транзисторы с имплантированными кремнием слоями AlN на сапфировых подложках. Наши диоды способны работать при температуре 827 °C (см. рисунок 4), превосходя все предыдущие рекорды, а наши транзисторы могут работать при температуре до 727 °C (см. рисунок 5). Диоды с барьером Шоттки AlN имеют напряжение пробоя 610 В при комнатной температуре, тогда как соответствующее значение для AlN MESFET при 727 °C составляет 176 В. Мы хотим отметить, что эти устройства практически осуществимы, поскольку они имеют простую конструкцию. структура, а слои AlN выращиваются на больших и недорогих подложках из сапфира.
Для изготовления наших диодов с барьером Шоттки и MESFET мы использовали Ni/Au для контактов анода и затвора. Мы обнаружили, что никель термически стабилен и практически не реагирует с AlN даже при 827 °C. Более того, с точки зрения электрических характеристик мы обнаружили небольшую разницу между Ni/Au и Pt/Au. Для диода с барьером Шоттки ток отключения мал даже при 827 °C из-за низкой концентрации собственных носителей заряда и термически стабильного интерфейса Ni/AlN. Однако ток стока AlN MESFET в закрытом состоянии высок при температуре 727 °C из-за утечки через нижние нелегированные слои AlN и высокой концентрации дефектов. В отличие от тока в кремниевых устройствах, который падает при высоких температурах из-за рассеяния фононов, мы обнаружили, что прямой ток AlN-диодов с барьером Шоттки и МОП-транзисторов продолжает увеличиваться с температурой до 827 °C. Мы связываем это с тем, что в токе в устройствах AlN при экстремальных температурах преобладает увеличение концентрации электронов и уменьшение контактного сопротивления, при этом уменьшение подвижности электронов играет второстепенную роль.
Наша разработка устройств AlN прокладывает новый путь к созданию полупроводниковых устройств, которые могут работать при экстремальных температурах. Хотя существует компромисс между коэффициентом включения-выключения и температурой диодов и полевых транзисторов с барьером Шоттки (см. Рисунок 6), устройства AlN имеют большой потенциал для улучшения. Например, должно быть возможно увеличить соотношение включения/выключения при экстремальных температурах за счет сочетания гомоэпитаксиального роста и введения структуры JFET. Дополнительные улучшения могут быть достигнуты за счет внедрения термостойких омических контактов вместо Ti/Al/Ti/Au, что приведет к увеличению рабочей температуры до более чем 877 °C.
Для большинства приложений, работающих при экстремальных температурах, микросхемы должны работать надежно в течение длительного периода времени. Такие схемы изготавливаются по дополнительной технологии с n- и p-каналами. Инженеры Киотского университета разработали дополнительный логический элемент SiC JFET, который работает при температуре 350 °C. Мы надеемся продолжить нашу работу в том же направлении, создавая дополнительные JFET-транзисторы с гомоэпитаксиальными каналами AlN, способные работать в экстремальных условиях.
ХИРОНОРИ ОКУМУРА ИЗ УНИВЕРСИТЕТА ЦУКУБА
от https://compoundsemiconductor.net/article/118570/Extreme-temperature_devices_using_AlN
Почему вам нужны наши услуги, вы знаете, что получаете высококвалифицированных специалистов, обладающих знаниями и опытом, чтобы убедиться, что ваш проект выполнен должным образом и функционирует.
если вы хотите получить бесплатную консультацию, пожалуйста, начните заполнять форму:
Получайте информацию о распродажах, новости и обновления на свой почтовый ящик.
 闽ICP备19012761号-1
闽ICP备19012761号-1



